Computational modelling of atomic layer etching of chlorinated germanium surfaces by argon†
Abstract
The atomic layer etching of chlorinated germanium surfaces under argon bombardment was simulated using molecular dynamics with a newly fitted Tersoff potential. The chlorination energy determines the threshold energy for etching and the number of etched atoms in the bombardment phase. Etch rate is determined by bombardment energy.
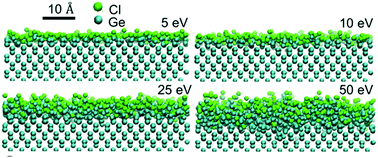


 Please wait while we load your content...
Please wait while we load your content...