Chain scission resists for extreme ultraviolet lithography based on high performance polysulfone-containing polymers†
Abstract
A series of
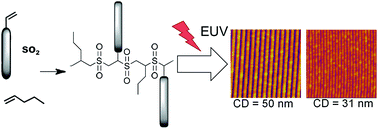
* Corresponding authors
a
The University of Queensland, Australian Institute for Bioengineering and Nanotechnology and Centre for Advanced Imaging, St Lucia, Queensland, Australia
E-mail:
a.whittaker@uq.edu.au
b Imec, Kapeldreef 75, B-3001, Leuven, Belgium
c The University of Queensland, Centre for Microscopy and Microanalysis, St Lucia, Queensland, Australia
d Intel Corporation, Hilsboro, Oregon, USA
A series of
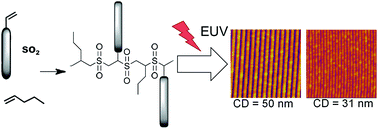
 Please wait while we load your content...
Something went wrong. Try again?
Please wait while we load your content...
Something went wrong. Try again?
K. J. Lawrie, I. Blakey, J. P. Blinco, H. H. Cheng, R. Gronheid, K. S. Jack, I. Pollentier, M. J. Leeson, T. R. Younkin and A. K. Whittaker, J. Mater. Chem., 2011, 21, 5629 DOI: 10.1039/C0JM03288C
To request permission to reproduce material from this article, please go to the Copyright Clearance Center request page.
If you are an author contributing to an RSC publication, you do not need to request permission provided correct acknowledgement is given.
If you are the author of this article, you do not need to request permission to reproduce figures and diagrams provided correct acknowledgement is given. If you want to reproduce the whole article in a third-party publication (excluding your thesis/dissertation for which permission is not required) please go to the Copyright Clearance Center request page.
Read more about how to correctly acknowledge RSC content.
 Fetching data from CrossRef.
Fetching data from CrossRef.
This may take some time to load.
Loading related content
