Enhancement of light emission in GaAs epilayers with graphene quantum dots
Abstract
A green and one-step synthesis of graphene quantum dots (GQDs) has been implemented using pulsed laser ablation from aqueous graphene. The synthesized GQDs are able to enhance the photoluminescence (PL) of GaAs epilayers after depositing them on the GaAs surface. An enhancement of PL intensity of a factor of 2.8 has been reached at a GQD concentration of 1.12 mg ml−1. On the basis of the PL dynamics, the PL enhancement in GaAs is interpreted by the carrier transfer from GQDs to GaAs due to the work function difference between them.
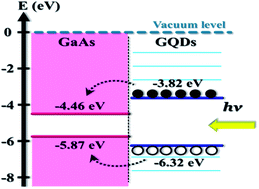

 Please wait while we load your content...
Please wait while we load your content...