A new method to characterize underlying scratches on SiC wafers
Abstract
We report a new method to reveal the underlying scratches that are usually unseen under optical microscopy on SiC wafers after chemo-mechanical polishing (CMP) treatment. After scanning Si terminated surfaces using a picosecond pulsed laser (355 nm) for a short duration, the scratches are clearly revealed under an optical microscope. The damage thresholds by the picosecond pulsed laser are obtained for 4H- and 6H-SiC. We demonstrate that this method is equally effective in unravelling these underlying scratches as other existing state-of-art methods including those etched by molten KOH at about 400–500 °C. The method is quick, facile, less-destructive and sensitive in characterizing the underlying surface scratches. It has great potential to find practical application in quality control for SiC wafers.
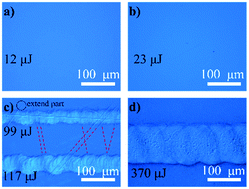


 Please wait while we load your content...
Please wait while we load your content...