Depth resolution at organic interfaces sputtered by argon gas cluster ions: the effect of energy, angle and cluster size
Abstract
An analysis is presented of the effect of experimental parameters such as energy, angle and cluster size on the depth resolution in depth profiling organic materials using Ar gas cluster ions. The first results are presented of the incident ion angle dependence of the depth resolution, obtained at the Irganox 1010 to silicon interface, from profiles by X-ray photoelectron spectrometry (XPS). By analysis of all relevant published depth profile data, it is shown that such data, from delta layers in secondary ion mass spectrometry (SIMS), correlate with the XPS data from interfaces if it is assumed that the monolayers of the Irganox 1010 adjacent to the wafer substrate surface have an enhanced sputtering rate. SIMS data confirm this enhancement. These results show that the traditional relation for the depth resolution, FWHM = 2.1Y1/3 or slightly better, FWHM = PXY1/3/n0.2, where n is the argon gas cluster size, and PX is a parameter for each material are valid both at the 45° incidence angle of the argon gas cluster sputtering ions used in most studies and at all angles from 0° to 80°. This implies that, for optimal depth profile resolution, 0° or >75° incidence may be significantly better than the 45° traditionally used, especially for the low energy per atom settings required for the best resolved profiles in organic materials. A detailed analysis, however, shows that the FWHM requires a constant contribution added in quadrature to the above such that there are minimal improvements at 0° or greater than 75°. A critical test at 75° confirms the presence of this constant contribution.
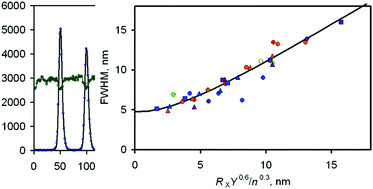

 Please wait while we load your content...
Please wait while we load your content...