Fabrication of highly ordered sub-20 nm silicon nanopillars by block copolymerlithography combined with resist design†
Abstract
The control of order and orientation of the self-assembly of cylinder-forming poly(styrene-b-dimethylsiloxane)
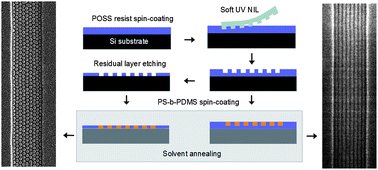
Maintenance work is planned for Wednesday 1st May 2024 from 9:00am to 11:00am (BST).
During this time, the performance of our website may be affected - searches may run slowly and some pages may be temporarily unavailable. If this happens, please try refreshing your web browser or try waiting two to three minutes before trying again.
We apologise for any inconvenience this might cause and thank you for your patience.
* Corresponding authors
a
Laboratoire des Technologies de la Microélectronique, CNRS/UJF-Grenoble1/CEA LTM, 17 rue des Martyrs, 38054 Grenoble, France
E-mail:
Marc.zelsmann@cea.fr
b Tyndall National Institute, Lee Maltings, Prospect Row, Cork, Ireland
c Department of Chemistry, University College Cork, Cork, Ireland
d Catalan Institute of Nanotechnology, Campus de la UAB, Edifici CM3, 08193 Bellaterra, Spain
e Profactor GmbH, Functional Surfaces and Nanostructures, 4407 Steyr-Gleink, Austria
f Intel Ireland Limited, Collinstown Industrial Estate, Co. Kildare, Leixlip, Ireland
g Catalan Institute of Research and Advanced Studies (ICREA), 08010 Barcelona, Spain
h Physics Department, Universitat Autònoma de Barcelona, Campus de la UAB, 08193 Bellaterra, Spain
i Centre for Research on Adaptive Nanostructures and Nanodevices (CRANN), Trinity College Dublin, Dublin, Ireland
The control of order and orientation of the self-assembly of cylinder-forming poly(styrene-b-dimethylsiloxane)
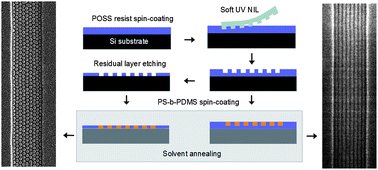
 Please wait while we load your content...
Something went wrong. Try again?
Please wait while we load your content...
Something went wrong. Try again?
M. Salaun, M. Zelsmann, S. Archambault, D. Borah, N. Kehagias, C. Simao, O. Lorret, M. T. Shaw, C. M. Sotomayor Torres and M. A. Morris, J. Mater. Chem. C, 2013, 1, 3544 DOI: 10.1039/C3TC30300D
To request permission to reproduce material from this article, please go to the Copyright Clearance Center request page.
If you are an author contributing to an RSC publication, you do not need to request permission provided correct acknowledgement is given.
If you are the author of this article, you do not need to request permission to reproduce figures and diagrams provided correct acknowledgement is given. If you want to reproduce the whole article in a third-party publication (excluding your thesis/dissertation for which permission is not required) please go to the Copyright Clearance Center request page.
Read more about how to correctly acknowledge RSC content.
 Fetching data from CrossRef.
Fetching data from CrossRef.
This may take some time to load.
Loading related content
