A new method to eliminate the influence of in situ contamination in SIMS analysis of hydrogen
Abstract
A new method has been developed that allows us to eliminate the influence of hydrogen contamination/background in
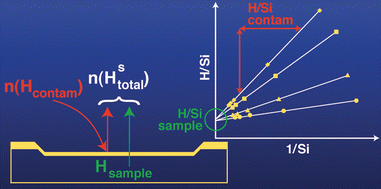
* Corresponding authors
a
Mineralogisches Institut der Universität Heidelberg, Im Neuenheimer Feld 236, D-69120 Heidelberg, Germany
E-mail:
thomas.ludwig@min.uni-heidelberg.de
b Geowissenschaftliches Zentrum der Universität Göttingen, Abteilung Mineralogie, Goldschmidtstraße 1, D-37077 Göttingen, Germany
A new method has been developed that allows us to eliminate the influence of hydrogen contamination/background in
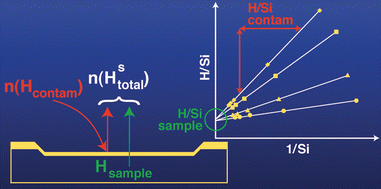
 Please wait while we load your content...
Something went wrong. Try again?
Please wait while we load your content...
Something went wrong. Try again?
T. Ludwig and R. Stalder, J. Anal. At. Spectrom., 2007, 22, 1415 DOI: 10.1039/B705848A
To request permission to reproduce material from this article, please go to the Copyright Clearance Center request page.
If you are an author contributing to an RSC publication, you do not need to request permission provided correct acknowledgement is given.
If you are the author of this article, you do not need to request permission to reproduce figures and diagrams provided correct acknowledgement is given. If you want to reproduce the whole article in a third-party publication (excluding your thesis/dissertation for which permission is not required) please go to the Copyright Clearance Center request page.
Read more about how to correctly acknowledge RSC content.
 Fetching data from CrossRef.
Fetching data from CrossRef.
This may take some time to load.
Loading related content
