Sealed ultra low-k organosilica films with improved electrical, mechanical and chemical properties
Abstract
In this contribution, we present sealed ultra low-k organosilica films that have improved electrical, mechanical and chemical properties. The films consist of a mesoporous
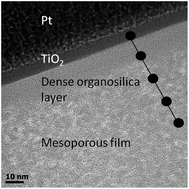

 Please wait while we load your content...
Please wait while we load your content...